第7章 最先端加工
4. 透明材料の3次元微細加工
1. はじめに
本節では、フェムト秒レーザーを用いた透明材料の3次元微細加工について述べる。特に我々がおこなっているフェムト秒レーザーの干渉光を利用した3次元加工に焦点を置く。
フェムト秒レーザーから発せられるパルス光は、時間幅が数十から数百fsと極端に短く、かつCWやナノ秒パルスレーザーと比べて桁違いに強い尖塔エネルギー持つている。そのフェムト秒レーザーパルスを数十μmの点に集光すると、その集光点での尖塔値は、〜100TW/cm2をゆうに超えた、高密度フォトンパルスまたは超高電界パルス光となって、加工対象の材料との間に様々な相互作用を誘起する。その相互作用によって、今まで光で直接加工することが不可能であった材料を加工することが可能となる。さらに一般的な加工法による切削加工や、CWレーザー、ナノ秒パルスレーザー、電子ビーム、イオンビームを使った従来のビーム加工技術では決してまねできない加工によって、新しいディバイスを創成できる可能性を秘めている。
フェムト秒レーザー加工で見られる特徴の一っとして、加工精度の良さがある。フェムト秒レーザー加工精度は、従来の切削加工法やナノ秒レーザーを用いた光加工に匹敵、もしくはそれを超えた事ができる。とくに加工のために必要なエネルギー闕値を上手く利用すると、光の回折限界を超えた精度、つまりナノサイズ領域での加工が可能である1〜3)。
もう一つの特徴として、バンドギャップの大きい材料、いわゆる透明材料を光で加工することが可能であることが挙げられる。通常、レーザー光の波長を吸収しない透明材料を光で加工することは、かなり困難である。ところがフェムト秒レーザーの場合、そのような透明材料も非常に簡単に加工することができる。フェムト秒パルスが作り出す高エネルギーパルス光は・多光子吸収やトンネルイオン化といった非線形効果を材料中に誘起する。それら非線形効果を介することで、レーザーのエネルギーが材料に付与され、透明、不透明に関係なく、ほとんど全ての材料を加工することができる。例えばSiO2(結晶、ガラス)、Al2O3、MgF2、CaF2、LiFなど、その透明領域が真空紫外域にまで広がる材料であっても、波長800nmの近赤外のフェムトパルスで容易に加工することができるのである4、5)。
フェムト秒レーザーを使った透明材料加工における最も大きな特徴は、単なる表面加工だけでなく、透明材料の内部を加工できる点にある。レーザーを照射したときに試料中に誘起される非線形光学過程は、十分に強い光電場があるときのみ誘起される。つまり、透明試料内部にフェムト秒レーザー光を集光して、3次元的な加工をおこなうことが可能である。大きな開口数(NA)の対物レンズで急峻に集光した場合、集光点から少しでもズレた位置での光電場強度は極端に小さく、非線形効果は殆ど誘起されない。従って集光部分は加工できるが、入射表面やその他の部分は影響を全く受けないので、高精度な3次元微細加工を試料内部に施すことができる(図1)。実際にフェムト秒レーザーを使った透明試料内部の加工例がこれまでに数多く報告されている。
近赤外波長(〜800nm)のフェムト秒レーザーによる、透明試料の内部加工に関係した主な報告を表1にまとめた。加工方法は大きく2つに分けることができる。①試料内部に誘起される屈折率の変化、または格子欠陥の生成を利用した加工、②試料内部に空洞を形成する加工、の2つである。
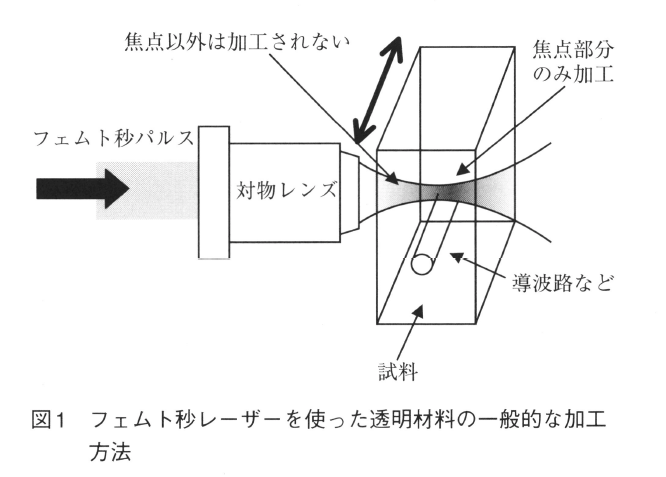
目次へ ∧
また、この屈折率の変化を利用すると、導波路だけでなく屈折率変調型の回折格子をも、試料内部に作ることができる。SiO2ガラスやLiF結晶内部でフェムト秒パルスを干渉させて、ホログラフィック回折格子を書き込んだ例が報告されている17、18)回折格子の書き込みについては、後の章で詳しく述べる。
レーザー照射による屈折率変化以外に、材料内部に発生した格子欠陥を利用した加工もおこなわれている。材料によっては、フェムト秒パルスで誘起された格子欠陥が、特定の蛍光を発する場合がある。Si2ガラス内部にフェムト秒パルスを照射すると、その部分は波長490nmに蛍光ピークを持つ欠陥が誘起される。直径〜600nm程度の蛍光を発する微小なスポットを三次元的に配列し、高集積光メモリーを作ることができる19、20)。データーを記録したガラスは、〜400°Cでアニールすると、データーは完全に消去されて、再利用することができる。また、ガラスに融解させた希土類イオンの価数を集光フエムト秒レーザーで変化させ、直径〜200nmの微小蛍光スポットの作成も報告られている21)。
目次へ ∧
化学的なプロセスを用いる方法は、より大きな3次元的な構造を試料内部に作成することができる。SiO2ガラスの場合、フェムト秒パルスを照射した部分のガラスの骨格構造が大きく変化する。それに伴って、照射部分の酸に対する溶解度が大きく向上する27)。光導波路を作るときと同じ要領で帯状にレーザーを照射し、その試料をHF溶液に入れてエッチング処理をおこなう。レーザー照射部分は非常に溶けやすくなっているため、照射部分の端面から徐々に溶解して3次元的な細長いチャネル(直径〜10μmの管)を試料内部に作ることができる28)。透明で化学的耐久性が良いSiO2ガラス内に溶液を流すことができるチャネルを自由な形状に構築できるため、μ-TAS’s(micrototal-analysis systems)などへの応用が期待される。また、SiO2スよりも光に敏感で、エッチング速度が速い感光性ガラスを用いると、さらに複雑なディバイスを作成できる。市販される光加工用のガラスFoturanを使い、約2mm四方の内部に色素レーザーを作成した例が報告されている29、30)。色素を流す為の流路と、レーザー共振器のミラー全てが組み込まれており、外部から励起光を入射させるだけで発振させることができ、〜10μWの出力が得られている。
目次へ ∧
2. フェムト秒干渉露光法によるSiO2ガラス内部の加工
本項では、具体的な透明材料の内部加工の例として、我々がおこなっているフェムト秒レーザーシングルパルス干渉露光法による加工結果について述べる。
フェムト秒パルスはナノ秒、ピコ秒レーザーに比べて高い可干渉性持っている。従って、フェムト秒パルスを重ねると容易に干渉し、その干渉縞を観測することができる。我々は、フェムト秒パルスの干渉縞をホログラフィック回折格子として、様々な材料に書き込むことに成功した31、32)。しかも高エネルギーのフェムト秒パルスを使うことで、たった1パルスの干渉パルスで、直径数十μmの微小な回折格子を書き込むことができる。マルチショットによる加工に比べて短時間で加工できるほか、レーザーパワーの揺らぎや、光学装置の振動の影響を受けにくいという利点がある。本手法は、透明材料の表面31、33)と内部18)の両方に回折格子を書き込むことができるが、以下では内部に試料の書き込んだ結果を中心に記す。
目次へ ∧
2.1 フェムト秒干渉露光装置
図2にフェムト秒レーザーシングルパルス干渉露光装置の概略図を示す。光源には再生増幅モードロック・チタンサファイアレーザー(中心波長:800mn、パルス時間幅:〜100fs、パルスエネルギー:最大約3mJ/pulse、繰り返し周波数:10Hz)を用いた。フェムト秒パルスを1発だけ取り出し、ビームスプリッターで2つの異なった光路に分けたあと、それぞれのパルスを凸レンズで集光、その集光点をサンプルの表面または内部の同一点で合致させて干渉させる。ビームスポット内部に発生した干渉パターンは、照射で試料の表面または内部に転写される。ただし、フェムト秒レーザーパルスを干渉させるには、回折格子を書き込む位置で2つのフェムト秒パルス光を時間的、空間的に一致させる必要がある。光学系の調整方法、表面回折格子の詳しい内容は引用文献31、33)で述べている。形成される回折格子の大きさは、書き込み条件によって直径数十〜数百μmと変化する。大面積の回折格子構造が必要な場合は、試料を電動ステージでレーザーの繰り返し周波数と同期させて動かすことで、試料全面に書くことができる。また、任意の形に回折格子を並べたり、光学顕微鏡で照射部位を観察しながら既存の光導波路の上に、回折格子を後から書き込むといったことも可能である。

図3に純粋なSiO2ガラス表面に書き込んだ回折格子の光学顕微鏡写真と、その断面を走査型電子顕微鏡で観察した結果を示した。二つのビームが会合する点を試料表面に設定すると、その表面に回折格子が形成される。直径約60μmのビームスポット内に、一様に回折格子構造が書き込まれていることが分かる。各ビームスポットはたった1発のパルス照射で形成される(図3(a))。回折格子の断面を走査型電子顕微鏡(SEM)で観察すると、回折格子の溝の深さは約1μm程度であることが分かる(図3(b))・回折格子の溝間隔dは、パルスの会合角度/により変化させることができ、d=2.6μm(θ=20°)〜d=430nm(θ=160°)の回折格子の書くことができる。これらの回折格子を透明試料の内部に書き込む方法を、次に述べる。
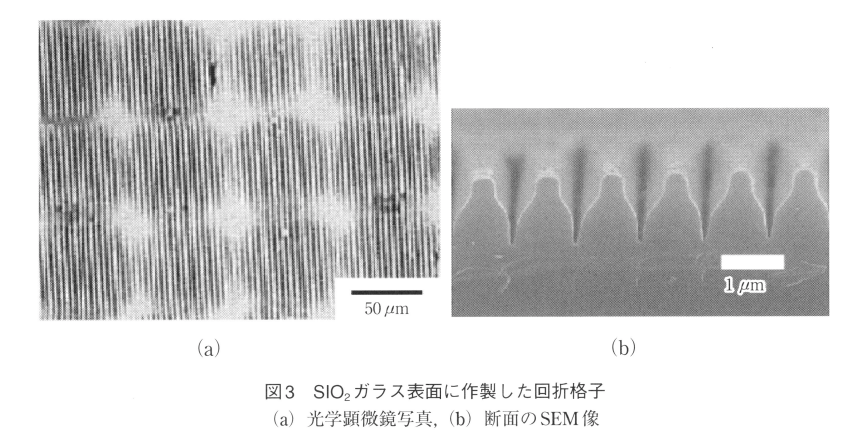
目次へ ∧
2.2 透明試料内部への回折格子の書き込み
ここではSiO2ガラスの内部に回折格子を書き込んだ例を示す。透明試料の内部で2つのパルスを衝突させると、図4に示す埋め込み型の屈折率変調型回折格子を作ることができる18)。図4の試料は、Si02ガラス(厚さ5mm)の内部に2層の回折格子のアレイを書き込んである。それぞれの層は、表面から約2mmと3mmと非常に深い部分に回折格子が形成されている。我々はこのように、表面から数ミリと深い部分に回折格子を書き込むために、パルスの時間幅を500fsに広げて(チャーピング)書き込みをおこなった(その理由は、次の章で説明する)。
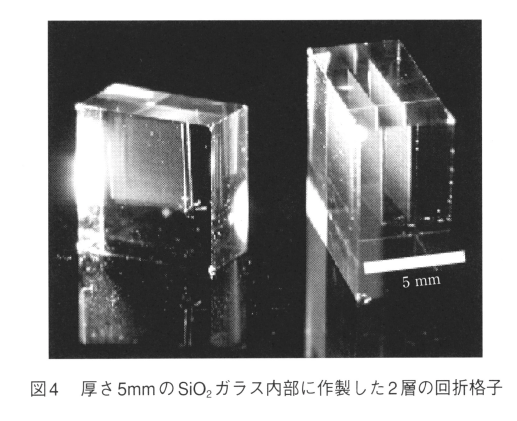
図5(a)の断面SEM像は、厚さ1mmのシリカガラス基板の中に書き込まれた4層の回折格子アレイの断面を示している。回折格子書き込んだあと、図5(b)は第1層の回折格子を拡大したものを示している。パルスが交差した部分には明瞭な回折格子の断面が観測できるが、試料を切断した段階では、このような回折格子を観察することはできない。図5の回折格子の構造は、断面をHF溶液で数分エッチング処理することで観察される。つまりフエムト秒レーザーの干渉光で、シリカガラスの内部に作製した回折格子は、クラックなどで構成されたものではないことを示している。図6に回折格子が形成された領域の赤外光反射スペクトルを示す。SiO2ガラスの骨格構造を構成する、Si-O-SiO伸縮振動に起因するω4(TO)(波数:1100cm-2)34)のピークの変化を示した。レーザーの照射前後で約6cm1程度低波数側にシフトしている。この変化はSi-0-Siの結合角度の減少に帰因し、ガラスの高密度化が起きていることを示唆し35、36)、6cm-1のシフトは〜1.5°のSi-O-Si結合角度減少に相当する37)。先にも述べたように、SiO2ガラス中に図6に示される構造の変化が誘起されると、屈折率の増加6、7)と酸に対する溶解度が向上する27)。つまり図5で観察された回折格子は、SiO2ガラスの変化部分が選択的にエッチングされた結果、回折格子の構造として観察され、屈折率変調型の回折格子が形成されていることも分かる。このような屈折率変調型の回折格子はSiO2ガラスだけでなく、Al2O3やLiFなどの単結晶でも作製する事ができることを確認している。
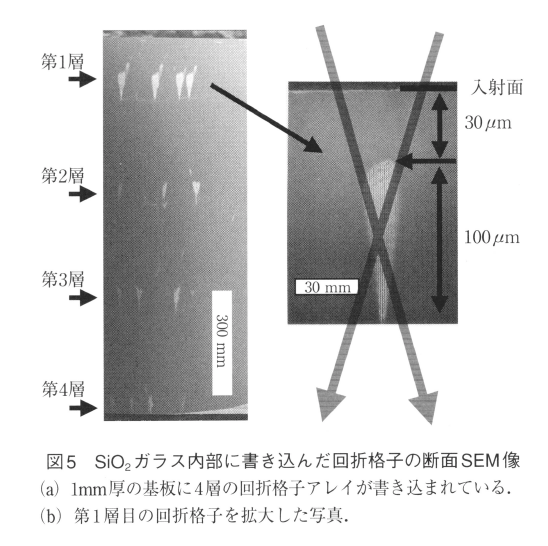
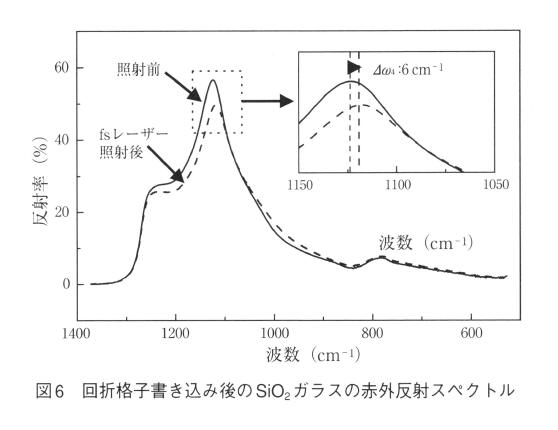
図7には2重露光によってSiO2ガラス内部に作製した、3次元の周期構造を示した。図7(a)はレーザー共焦点顕微鏡で測定した3次元像を示している。図7(b)は微分干渉顕微鏡(透過)でみた内部の構造である。直交させた回折格子を重ねて書き込むだけで、図7に示すような3次元周期構造を作り込むことができる。
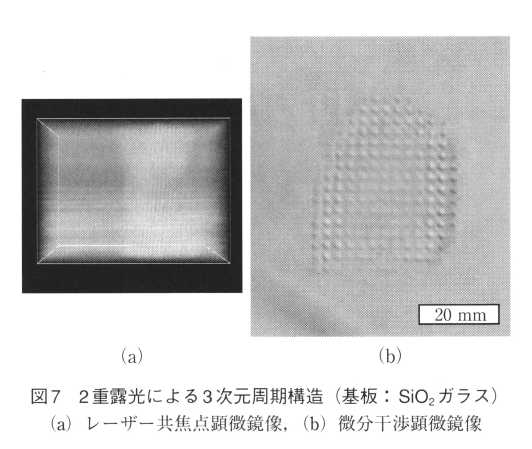
目次へ ∧
2.3 内部加工におけるチャープパルスの効果
フェムト秒加工で最も用いられる100fs前後のパルスを使って、SiO2ガラスなどの内部加工を試みると、図5に示した試料のような表面から数mmと深い部分を加工することは非常に困難である。最初で述べたように、フエムト秒レーザーで内部加工をおこなう場合、図1に示したように対物レンズで急峻に集光する方法が一般的である。焦点位置以外のエネルギー密度を小さくして、入射表面や、その他で意図しないダメージを避けることができる。一方、大きなNAを持つ対物レンズの作動距離は非常に小さく、極限られた領域のみの加工しかできない。対物レンズを使った干渉光による回折格子書き込みが報告されているが、表面から数百μmが限界である17)。パルス幅を500fsにチャープさせたパルスを使うと、焦点距離が50mmといった長焦点レンズでも、図5のように内部加工をおこなうことができる。
図8には100fsとチャープパルス(500fs)を使って、SiO2ガラス表面に書き込んだ回折格子の断面SEM像を示した。集光は両方とも焦点距離50mmの凸レンズでおこなった。写真はHF処理をした後の状態を示している。100fsパルスで書き込んだ場合、表面より内部では。全く回折格子の構造を確認することができない。一方、チヤープパルスで書き込んだ場合は、表面から100μm近くまで回折格子が形成されていることが分かる。2つパルスが交わる位置は両者とも全く同じ条件で書き込んでいるにもかかわらず、100fsのパルスの場合は、内部に一切の変化を確認することができない。
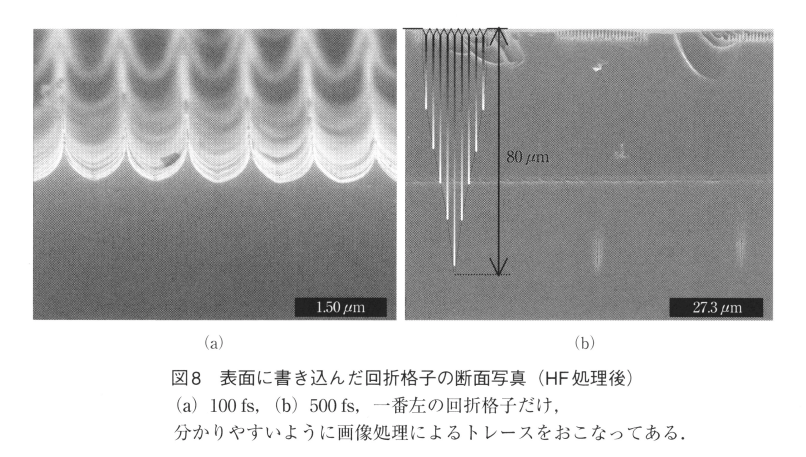
100fs秒パルスのように高強度パルスを透明材料に照射すると、トンネルイオン化や多光子吸収、さらに衝突イオン化プロセスなどによって1021cm-3を超える高密度フリーキャリアが瞬時に生成される38)。そのような高濃度のフリーキャリアが生成すると、その電子プラズマによる吸収はレーザーの発振波長にまで到達する。つまり、1021cm-3を超える高密度フリーキャリアが生成すると、それ以降のレーザー光は、自ら作り出したフリーキャリアによって吸収、または反射されてしまい、試料内部にまで到達することができない。しかし、光はプラズマによって直接(一光子過程)に吸収され、アブレーションなど、材料加工に十分なエネルギーを電子に与えことができる。一方チャープさせたパルスの場合、その尖塔値は100fs秒に比べてかなり小さくなり、瞬時に1021cm-3を超える高密度フリーキャリアを作ることができないと考えられる。計算による結果と、100fsのパルスの場合、そのフリーキャリアのほとんどはトンネルイオン化または多光子吸収だけで、瞬時に1021cm-3を超えるキャリアが生成されるが、200fsにチャープさせたパルスの場合には、アバランシェなどの衝突イオン化プロセスによるキャリア濃度増加プロセスの寄与が、大きくなることが報告されている39)。つまりパルス幅が大きくなると、卜ンネルイオン化や多光子吸収によって、初期に低濃度のフリーキャリアが生成し、それを種電子とした衝突イオン化プロセスによって、時間とともにキャリア濃度が増加することになる。従ってチャープパルスの場合、1021cm-3を超えるには、ある程度の時間を必要とし、その時間内に表面より内部に光が進入できると考えられる。その後は、衝突イオン化プロセスによるキャリア濃度増加が起きるが。それにはある闕値以上のエネルギーが必要となるため、実際に加工されるのは焦点付近に限られると考えられる。
目次へ ∧
2.4 LiF単結晶への光導波路と分布帰還型カラーセンターレーザーの作製
フェムト秒レーザーで実際に作製した光学ディバイスの例として、LiF単結晶中に作製した光導波路と分布帰還型(Distributed-FeedBack)カラーセンターレーザーについて述べる15、40)。アルカリハライド結晶には、数多くのカラーセンターが存在するので、その光学的特徴を使った光学ディバイスへの応用が考えられる。その中でも、LiF結晶中に存在するカラーセンターには、室温で安定かつ可視域での発光とレーザー活性を持つものが存在する。古くからしiF結晶をベースにした室温カラーセンターレーザーの実験が、数多くおこなわれており、F2*中心(蛍光波長λ=0.65〜0.74μm)、F3*中心(蛍光波長λ=0.51〜0.57μm)等のレーザーの発振が報告されている41〜43)・さらに、外部共振器による発振だけでなく、超音波や紫外線レーザーの干渉光による過渡的な回折格子を利用した低温でのDFBレーザーの発振に成功例もある43)。しかしこれらの場合、回折格子は過渡的に存在するだけで、実験後、直ちに回折格子は消失してしまう。これまで永久的な回折格子を作製してDFEレーザー発振に成功した例はない。
LiF結晶は単なるレーザー媒質としてだけでなく、その内部に光導波路を書き込むことができる。高濃度のカラーセンターを誘起させると、その部分の屈折率が増加することが分かっている44)。つまり、カラーセンターを帯状に誘起させることによって、導波路として機能させることができる。同様に回折格子も書き込めることを意味しており、LiF結晶内部にレーザー、導波路、回折格子という、主要な光回路の構成要素を全て埋め込んだ、3次元光集積回路を実現できる可能性を持っている。しかし、LiF結晶の光学バンドギャプは、14eVと他の材料に比べ極端に大きく、光などで結晶の表面や内部に、精度の高い永久的なグレーティングを作製する方法が無かったため、これまで実現されていない。このような材料であってもフェムト秒レーザーを使うと簡単に加工することができ、かつ、色中心をも誘起できる15、40)。図9にLiF結晶中にフェムト秒パルスで作製した光導波路と、実際にHe-Neレーザーの光(633mn)を導波させている様子示した。図9(a)は、532nmの光を試料に照射したときに、導波路から発せられるF2センターの蛍光(赤色)のイメージを示している。またHe-Neレーザーの臨界入射角度から、レーザー照射によって約+1%の屈折率増加が誘起されていることが分かった。
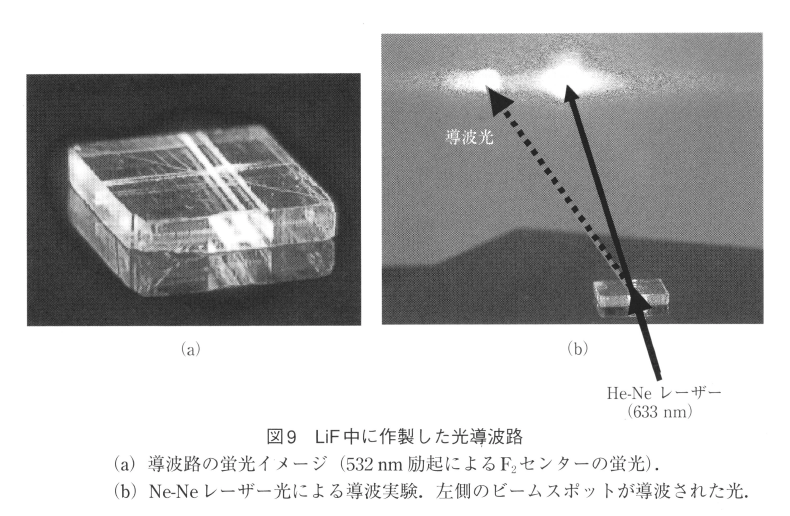
図10には、干渉パルスで作製したDFBレーザーの構成を示す。フェムト秒シングルパルス干渉露光法を使い、結晶内部に表面から〜100μmの深さに、回折格子を長さ約10mmのアレイ状に書き込んだ。書き込まれた回折格子は室温でも安定で、またかなり強い光を照射しても消失することはない。レーザー発振に利用したカラーセンターは、室温で安定に存在でき、さらに可視域でレーザー発振可能(〜700nm)なF2中心を選択した。F2中心の発振可能波長域に合わせ、格子間隔dを510nm(発振波長710nm)に設定した。他の材料と同様に、LiFの場合も一つのマイクログレーティングは、1パルスで書き込むことができる。レーザー発振は、励起光にシリンドリカルレンズで集光した450nmのレーザー光を用いて、グレーティングアレイ全体に集光した。そのときの発光を、CCD分光器で観測した結果を図11(b)に示した。グレーティングを書き込んである部分では、707nm付近に非常に鋭い発光が見られ、その半値幅は分光器の分解能1nm以下であった。グレーティング以外の場所ではブロードな蛍光のみが観測された。また、設計波長710nmと観測された発振波長がほぼー致していることから、作製したグレーティングがDFBとして機能していることがわかる。今までに、最大約10%の変換効率、ビーム拡散角0.2°が得られている。図11(a)にDFBレーザー発振の様子を撮った写真を示す。スクリーン上に明るいビームスポットをはっきり見る事ができる。
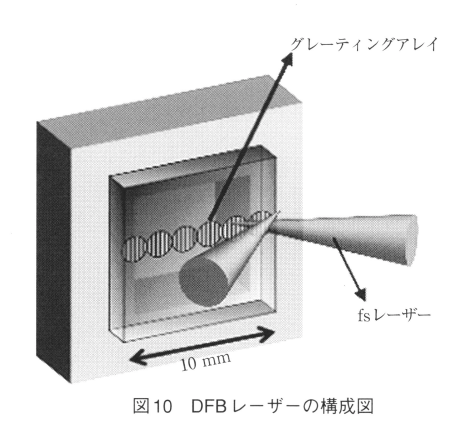
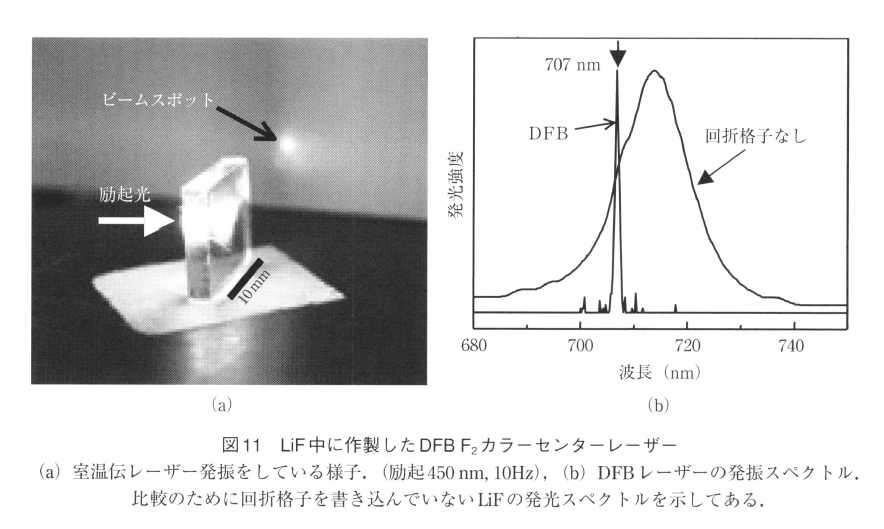
目次へ ∧
3. おわりに
硬質の透明材料の内部を加工することは、これまで不可能であり、短パルスレーザーに登場によって初めて可能になった。尖頭電場が際立って大きいため、顕著な非線形効果によて、このような加工ができるのである。内部加工の中でも光の干渉を利用した回折格子の書き込みは、最も難度が高いものの一つに挙げられてきたが、本稿で記した方法で何とか実現することができた。本稿で記した装置は、今春から計測機メーカにより市販されている。興味にある方URL(http://www.tokyoinst.co.jp/products/nano/cat/nano02/FLMNsystem.pdf)を訪ねて頂きたい。結晶の内部に光集積回路を形成し、実用性のある能動デバイスを実現することが、次の研究課題となっている。今後の更なる展開が期待される。
目次へ ∧
[参考文献]
1) E.N.Glezer, M.Milosavljevic, L.Huang, R.J.Finlay, T.-H.Her, J.P.Callan, and E.Mazur:Opt.Lett., 21, 2023(1996)
2) K.Kawamura, N.Sarukura, M.Hirano, N.Ito and H.Hosono:Appl.Phys.Lett., 79, 1228(2001)
3) M.Watanabe, S.Juodkazis, H.Sun, S.Matsuo, H.Misawa, M.Miwaand R.Kaneko:Appl.Phys.Lett., 74, 3957(1999)
4) B.C.Stuart, M.D.Feit, S.Herman, A.M.Rubenchik, B.W.Shore, and M.D.Perry:J.Opt.Soc.Am.B., 13, 459(1996)
5) D.Ashkenasi, A.Rosenfeld, H.Varel, M.Wahmer, and E.E.B.Campbell:Appl.Surf.Sci., 120, 65(1997)
6) K.M.Davis, K.Miura, N.Sugimoto, and KHirao:Opt.Lett., 21, 1729(1996)
7) V.R.Bhardwaj, E.Simova, a!P.B.Corkum, and DM.Rayner, C.Hnatovsky, R.S.Taylor, B.Schreder, M.Kluge, and J.Zimmer:J.Appl.Phys., 97, 083102(2005)
8) K.Miura, J.Qiu, H.Inouye, T.Mitsuyu, and KHirao:Appt.Phys.Lett., 71, 3329(1997)
9) M.Streltsovand N.F.Borrelli:Opt.Lett., 26, 42(2001)
10) C.B.Schaffer, A.Brodeur, J.F.Garcia, and E.Mazur:Opt.Lett., 26, 93(2001)
11) A.M.Streltsovand N.F.Borrelli:J.Opt.Soc.Am.B., 19, 2496(2002)
12) R.Osellame, S.Taccheo, G.Cerullo, M.Maragoni, D.Polli, R.Ramponi, P.Laporta, and S.DeSilvestri :Electron.Lett.,3 & 964(2002)
13) M.Kamataand M.obara:Appl.Phys.A., 78, 85(2004)
14) V.Apostolopoulos, a) L.Laversenne, T.Colomb, C.Depeursinge, R.P.Salathe, M.Pollnau, R.Osellame, G.Cerullo, and P.Laporta:Appl.Phys.Lett., 83, 1122(2004)
15) K.Kawamura, M.Hirano, T.Kurobori, D.Takamizu, T.Kamiyaand H.Hosono:Appl.Phys.Lett., 84, 311(2004)
16) M.Kamata, M.Obara, R.R.Gattass, L.R.Cerami, and EricMazur:Appl.Phys.Lett., 87, 051106(2005)
17) Y.Lia, W.Watanabe, K.Yamada, T.Shinagawa, K.Itoh, J.Nishii, YJiang:Appl.Phys.Lett., 80, 1508(2002)
18) K.Kawamura, M.Hirano, T.Kamiyaand H.Hosono:Appl.Phys.Lett., 81, 1137(2002)
19) M.Watanabe, S.Juodkazis, H.Sun, S.Matsuo, and H.Misawa:Appl.Phys.Lett., 74, 3957(1999)
20) M.Watanabe, S.Juodkazis, H.Sun, S.Matsuo, and H.Misawa:Appl.Phys.Lett., 77, 13(2000)
21) K.Miuraa, J.Qiu, S.Fujiwara, S.Sakaguchi, and KHirao:Appl.Phys.Lett., 80, 2263(2002)
22) D.Homoelle, S.Wielandy, A.Gaeta, N.F.Borelli, and Ch.Smith:Opt.Lett., 24, 1311(1999)
23) K.Yamada, W.Watanabe, T.Toma, J.Nishii, and K.Itoh:Opt.Lett., 26, 19(2001)
24) C.B.Schaffer, A.Brodeur, J.F.Garcia, and E.Mazur:Opt.Lett., 26, 93(2001)
25) T.Gorelik, M.Will, S.Nolte, A.Tuennermann, and U.Glatzel:Appl.Phys.A., 76, 309(2003)
26) W.Watanabe, T.Toma, KYamada, J.Nishii, K.Hayashiand K.Itoh:Opt.Lett., 25, 1669(2000)
27) F.N.Schwettman, D.J.Dexter, and D.F.Cole:J.Electrochem.Soc., 120, 1566(1973)
28) A.Marcinkevivcius, S.Juodkazis, M.Watanabe, M.Miwa, S.Matsuo, H.Misawa, J.Nishii:Opt.Lett., 26, 277(2001)
29) M.Masuda, K.Sugioka, Y.Cheng, N.Aoki, M.Kawachi, K.Shihoyama, K.Toyoda, H.Helvajian, K.Midorikawa :Appl.Phys.A.,76,857(2003)
30) Y.Cheng, K.Sugioka, and K.Midorikawa :Opt.Lett., 29, 2007(2004)
31) K.Kawamura, T.Ogawa, N.Sarukura, M.Hirano and H.Hosono:Appl.Phys.B., 71, 119(2000)
32) K.Kawamura, N.Sarukura, M.Hirano and H.Hosono:Jpn.J.Appl.Phys., 39, L767(2000)
33) K.Kawamura, N.Ito, N.Sarukura, M.Hirano and H.Hosono:Rev.Sei.Instrum., 73, 1711(2002)
34) S.K.Sharma, D.W.Matson, J.A.Philpotts, T.L.Roush:J.Non-Cryst.Solids., 68, 99(1984)
35) H.Hosono:J.Appl.Phys., 69, 8079(1991)
36) R.A.B.Devine:Nucl.Instr, and Meth.B., 91, 379(1994)
37) H.Hosono, K.Kawamura, S.Matsuishi, and M.Hirano:Nucl.Instr, and Meth.B., 191, 89(2002)
38) B.C.Stuart, M.D.Feit, A.M.Rubenchik, B.W.Shore, and M.D.Perry:Phys.Rev.Lett., 74, 2248(1995)
39) A.Kaiser, B.Rehfeld, M.Vicanek, and G.Simon:Phys.Rev.B., 61, 11437(2000)
40) T.Kurobori, K.Kawamura, M.Hirano, and H.Hosono, J.Phys:Condens.Matter., 15, L399(2003)
41) T.T.Basiev, S.B.Mirov, and V.V.Osiko:IEEEJ.Quantum Electron., 24, 1052(1988)
42) T.Tsuboi and H.E.Gu:Appl.Opt.Commun., 55, 277(1985)
43) T.Kurobori, T.H.Hibino, Y.Q.Chen, and K.Inabe:Japan.J.Appl.Phys., 34, L894(1995)
44) M.Montecchi, E.Nichelatti, A.M.mancini, and R.M.Montereali:J.Appl.Phys., 86, 1(1999)
目次へ ∧

