33・5・1 光導波路パターニング
通常,フォトマスクを介してUV光を照射し,フォトレジストへの微細パターニングを行う.この手法は量産に適しているが,マスクを介してのパターン転写による精度の劣化が欠点であり,また仕様変更によるマザーマスクの作製が煩雑かつ高価である.これに対して,少量・多種にわたる微細パターニングやデバイス開発過程においては,集光レーザービームと精密微動ステージを組み合わせた直接描画が適している.これはマスクレスプロセスで,サブミクロン精度で大面積の微細パターニングが大気中で行えるのが特長である.
フォトレジストにUVレーザービームを集光して走査すれば,レジスト上に所望の線画パターンが一筆書きで容易に得られる.このようなレーザービーム(LB)描画の原型は1970年代後半にすでに報告されている9).ここで,LB揃画の線画パターニング精度は,レジストの厚さと集光レンズおよび光ドーズ量(集光LBの強度と走査速度の積)に依存する.露光後のレジストの断面形状が矩形またはアンダーカットであるような切れ味の良い線画パターンは,レジスト厚とレンズNAで決まる最適線幅でのみ得られる.しかし,わずかな線画のエッジの丸みを容認できれば,線幅は光ドーズ量によって広い範囲にわたって制御できる.また,線幅の一様性はLB走査速度とLB強度の安定性で決まる.描画面積は一様なLB走査が得られる範囲で決まり,既存の微動ステージを用いて10 cm角を超える大面積パターニングは容易に得られる.
プロトタイプの大面積・高精細ILB描画装置の構成を図33・15に示す.本装置は長さ40 mm以上の長尺の光導波路パターニング用に開発されたものである10).光源は波長442 nmのHe-Cdレーザーで,音響光学変調器(AOM)で強度変調し,ビーム整形をしてフォトレジスト上に集光する.レジストを塗布した基板を0.1 μmステップのクローズドループ制御X-Yステージ上に置き,曲線,斜め線を含めてこのステージを一定速度で走査できる.描画に際しては,まずポジフォトレジスト(Shipley # 1400-17/27)を塗布したLiNbO3またはガラス基板をステージ上に置き,焦点合せを行う.このあと,コンピュータに入力された所望のデータに従ってステージおよびAOMを駆動して,自動的に導波路をパターニングする.描画精度0.1 μm,最小線幅~0.5 μm,描画面積100×100 mm2,8ビット並列信号でLB強度変調,標準描画速度1.25 mm/sで,曲線,斜め線,分岐,交差,方向性結合器などさまざまな導波路パターニングが行える.3.5 μmのTi拡散導波路からなる測用光ICのサイズは4×32 mm2で,導波路の描画には約4分を要する11).LB描画後,現像,Ti膜リフトオフ,熱拡散の工程を経て作製したTi膜光導波路の顕微鏡写真を図33・16に示す.導波路のエッジのゆらぎ0.1 μmで,特に分岐角1/50 radできわめて鋭い切れ込みを持つY分岐導波路が得られる.
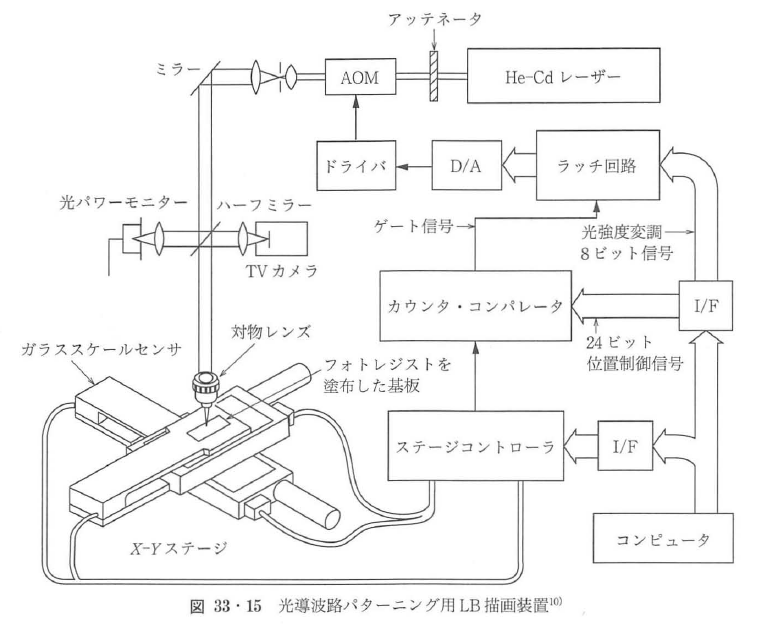
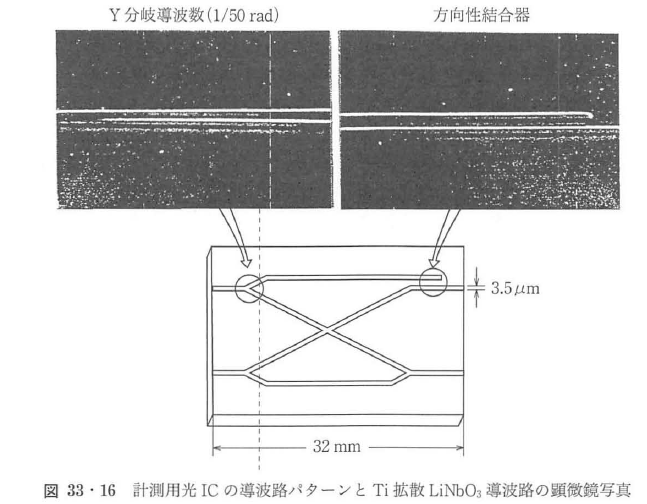
さらに,描画装置の光源としてAr+レーザーを用いることによって,LiNbO3基板上に堆積したTi膜を選択的に酸化し,TiO2ストライプ膜を形成できる12).これはレジストレスTi拡散導波路プロセスとして,また回折格子の作製に利用できる.
33・5・2 周期点列描画
無料ユーザー登録
登録することで3000以上ある記事全てを無料でご覧頂けます。
- @optipedia.info ドメインより登録の手続きを行うためのメールをお送りします。受信拒否設定をされている場合は、あらかじめ解除をお願いします。
- Gmailをお使いの方でメールが届かない場合は、Google Drive、Gmail、Googleフォトで保存容量が上限に達しているとメールの受信ができなくなります。空き容量をご確認ください。
