True Color可視化3D光干渉計でフレキシブルエレクトロニクスの理解向上
白色光干渉計(WLI)、位相シフト干渉計(PSI)、True Colorイメージングとスティッチングを1つの光学プロファイラに組み合わせることで、フレキシブルエレクトロニクスデバイス、材料及び製造を特性評価する。
3D光学プロファイリングは、非接触高分解能計測、可視化技術であり、デバイスや材料のトポグラフィ及び形状を計測するために使われる( 1)、( 2)。市販の3D干渉計システムの能力は着実に向上してきた。今日、それらは長さスケールでオングストロームから数ミリメートルの範囲で垂直ナノ及びマイクロトポグラフィを計測できる。米KLA社が開発したTrue Colorイメージングは、トポグラフィを補完する追加的理解を可能にする。オプトメカニカルハードウエア、オプティクス、エレクトロニクスやソフトウエアの進歩により、経済的な高精度3D干渉計測システムの構築が可能になっており、3Dプロファイリングは、広範な産業アプリケーション及び科学アプリケーションに有用になっている。
本稿では、この新しい世代の3D光学計測がプリンテッド及びフレキシブルエレクトロニクス分野へどのように適用されるかの例を紹介する。フレキシブルエレクトロニクスの特徴は、豊富で多様な一連の機能、デバイストポグラフィ、製造技術とさまざまな材料(導電、絶縁、誘電他など)である。これらは、多様な光学特性を持つ複雑な表面構造となっている。フレキシブル基板上のマルチパラメータプリントアレイは、湿度、温度、機械ひずみのセンシング、熱電ジェネレータ及び多くの他の目的のために利用できる。これらのすべての性能は、形状及び製造工程に依存する(3)。
実験法と結果
図 1aは、経済的な統合3D干渉光学プロファイラプラットフォームの例である。これには、白色光干渉計(WLI)、位相シフト干渉計(PSI)、True Colorイメージング、及びスティッチングを組み込んでいる。図1bは、干渉計システムの概略レイアウトである。それには、広帯域白色光源とMirau干渉対物レンズが搭載されていて、WLI、PSI、複合WLI+PSIを実行する。サンプルと内部Mirau参照ミラーからの反射光の干渉によりトポグラフィ依存干渉縞が生ずる。これを高分解能カメラで撮り、3Dトポグラフィックデータに変換する。サンプル着色についてのTrue Color情報も、トポグラフィックハイトの関数として取得される。図 2は、プロトタイプフレキシブル電子デバイスの計測例。これは、フレキシブルポリイミド基板上に2つの異なる材料の多層インクジェットプリンティングを用いて作製された( 5)、( 6)。この記事の3D画像は、Profilm解析環境内で解析されており、読者は利用できる(7)。デバイスは、多層インクジェットプリンティングで全面的に構築された3D複合構造。電気コンタクトは、インクジェットプリンティングで作製された。これは、濃縮された約100nm径の銀(Ag)ナノ粒子で満たされた80μm径ドロップとわずかにオーバーラップしている。導体トレースは、インクジェットプリンティング有機PEDOT:PSSによって形成された。これにはさまざまなwt%カーボン量子ドット(CQD)が混ざっており、部分的に前のインクジェットプリントされたAgナノ粒子コンタクトとオーバーラップしている。PEDOT:PSSは、一種の電気伝導性ポリマーの半透明材料であり、導電ウエアラブルフレキシブルファブリック、センシング、機能性エレクトロニクスに使用されている。CQDは、PEDOT:PSSの電気伝導性の可調性と光応答性を強化し、可能にする。インクジェット堆積材料のトポグラフィは、蒸発する溶媒の影響を受ける。従って、トポグラフィ計測とTrue Color計測により、プリントされたデバイス形状の迅速評価ができ、光カラーを製造工程に関係させることができる。

図1 コンパクトな3D干渉光学プロファイラを(a)(4)に示した。干渉計測のために、XYステージがサンプルの位置を合わせ、二方向にチルトして、サンプルを対物レンズ軸に合わせる。簡素化された光学設計も(b)示した。対物レンズの焦点は測定距離により垂直に走査される。低コヒーレンス長白色LED光源を各トポグラフィ干渉計測に使う。干渉計で決まる各トポグラフィックハイトで、サンプル表面をWLI、PSI、True Color計測する。
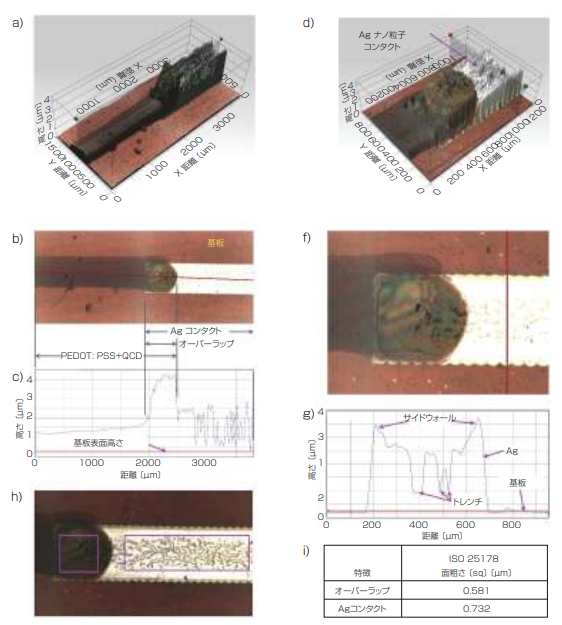
図2 2つのプリントされたパスPEDOT:PSS+10wt% QCDのWLI、トポグラフィの3Dビュー(a)とトップダウンビュー(b)を示している。プロットされた強度領域は、銀(Ag)コンタクト強度を満たすように調整されている。狙いは、導体の色とオーバーラップ領域をもっと明確に示すこと。導体の中央に沿った高さプロファイル、オーバーラップ領域、Agナノ粒子コンタクトも示されている(c)。水平な赤線は基板高さ。オーバーラップ領域Agコンタクトのクローズアップ(d)、Agナノ粒子コンタクトの横断面(e)、トップダウンビュー(f)は高さプロファイル(g)が計測されるところ、またオーバーラップのズームインビューとコンタクト領域はすべて示している。プロットされた強度領域は、Agコンタクト形態を可視化するように調整されている。マゼンタ長方形は、粗さ計測(h)の位置を示しており、(h)における粗さの表も示している(i)。
(もっと読む場合は出典元へ)
出典元
http://ex-press.jp/wp-content/uploads/2021/01/28-30_ft_interferometry.pdf
