光デバイス開発を加速するオン・シリコン加工基板
厚い(3-10μm)「オン・シリコン」加工基板−希土類酸化物の場合もある−が、現在そして次世代のフォトニックデバイスの大量需要に応えられるように生産されようとしている。
「オン・シリコン」III-V 技術により、シリコン製造業になじみのある基板にIII-V材料の特性を注入したすばらしい新世界が可能になるかも知れない。発光はIII-V材料の主要な利点であるが、シリコンよりも高い電子移動度により高速、ハイパワーアプリケーションが実現可能となる。これは、電圧調整器やインバータを必要とするLED照明業界にとっても重要である。
III-V−オン・シリコン技術プラットフォームにとって重要なことは、ウエハが平坦であることだ。窒化ガリウム(GaN)、ガリウム・ヒ素(GaAs)、インジウム・ガリウム・ヒ素(InGaAs)それにゲルマニウム(Ge)などの技術的に重要な材料をシリコン(Si)ウエハ上に置くとき、平坦性が大きな課題になる、これは主として熱膨張の問題によるものだ。
エピタキシで高温となる場合、基板とその上の層との間で熱膨張係数が大きく違うことにより冷却するとウエハが大きく反る。反りが大きすぎて、ウエハに物理的亀裂が生ずることもある。ウエハが反ると、ウエハ処理にスキャナやステッパーなどの標準的なシリコン業界のツールが使えなくなり、既存のシリコンインフラストラクチャを利用するウエハ処理の主要な利点がなくなる恐れがでてくる。したがって、反りを和らげる方策が大きな関心事になっている。
トランスルーセント社(Translucent)では、関心のある材料系に応じたオン・シリコン技術に向けて2つの一般的なアプローチを開発した。まず、改良版化学真空蒸着(CVD)装置を用いることでゲルマニウムはシリコンに直接成長できる。これは、シリコン基板ベース多接合型太陽電池アプリケーションやGaAsフォトニック集積アプリケーションにはよく適合している。理由は、貫通電極を維持できるのでデバイスアーキテクチャ再加工が不要となるからだ。第2のアプローチは、単結晶酸化バッファ層の利用。これにより、絶縁システム上にGaNを作製できる。これは、現在上面コンタクトを利用しているLED、電界効果トランジスタ(FET)のいずれかで基板として利用できる。
また、酸化物の誘電特性はパワーFETの電気パフォーマンスを改善することができる。われわれの基板は有機金属化学気相成長法(MOCVD)による成長向けのテンプレートに適しており、それに続くGaN成長は発光特性を実証している。酸化物結晶は追加の半導体層エピタキシをサポートしているので、酸化層と追加のシリコンエピタキシーをペアにしSi-GaN バッファ層に分布ブラッグ反射器(DBR)を埋め込むことも可能だ。
InGaAs on Siに近づくGe-on-Si
トランスルーセント社は、業界で一般的となっているSiGe組成評価スキームを用いずにシリコン基板への直接Geエピタキシを実証した。われわれの技術は、スズ(Sn)を加えて欠陥の広がりを制御し、他のⅣ族元素と二元、三元合金を作る(GeSn, SiGeSn)。これらの薄膜は、独自の改良型CVD工程を用いてシリコンに直接堆積する。一般的なソース(原料ガス)として、ジゲルマン(Ge2H6 )、トリシラン、重水素化スズ(SnD4)を用いている。当初の製品開発では、シリコン上に5μm厚Geを堆積することに注力していた。これは、ハイパフォーマンス、高効率多接合太陽電池で使用するバルクGe基板の置き換えだった。これには、0.1-0.5%の範囲でSn(スズ)が必要となる。
最初の静電容量電圧計測では、キャリア濃度1 × 10
成長レートが良いとは、その工程が量産に向くことを意味する。Geテンプレートは数μm 厚まで可能であり、多接合太陽電池、GaAs集積フォトニクス、また可能性としてはレーザベースなど、他の構造の出発点となる。シリコン基板が選ばれたのは、Geがバルク基板で現在使われているのと同じ結晶配向を持つようにするためである。つまりこれは、〈111〉方向に6°ミスカットしたSi (100〉上に成長させるPVテンプレート向けである。基板にボロン(B)を添加(シート抵抗0.01-0.02Ω-cm)したのは、100mm径、150mm径ウエハを用いる際に現在の装置の設定で裏面コンタクトを容易にするためだ。
トランスルーセント社の工程を用いて、英国IGE社がInGaAs膜をGeSnに直接成長した。室温フォトルミネセンス(PL)測定結果は、869nmでピークPLを示しており、これは多接合太陽電池エピタキシ構造でGe上に一般的に成長したGaAs(In0.02Ga0.98As)のIn濃度1-2%で期待できるものだ。もう1つ重要な点は、GeがIII-V材料に拡散しないことだ。IQEによる二次イオン質量分光(SIMS)プロットの示すところでは、エピタキシャル層からのGeはInGaAsに拡散しない、つまりこの材料はバルクGeと同様に安定的であることを示している(図2、3)。
GeSn層でスズ(Sn)濃度を変えると、Geの感度を赤外(IR)に伸ばすことになり、太陽照射の吸収能力を改善したGeSn太陽電池も可能になる。GeSn合金とすることで1eV動作の三元材料への道が開ける、このレベルの能力は太陽電池の効率を50%+レンジに押し上げるのに必要であると以前から言われてきた。シリコン基板に多接合太陽電池を作製するための基礎を築き、コストを下げ、集光型太陽光(CPV)発電産業で、より大きな基板を使用する可能性が増すという理由で、これはすばらしい技術である。

図1 透過型電子顕微鏡(TEM)から、ゲルマニウム/スズ(Ge/Sn)境界の不整合転位が分かる。
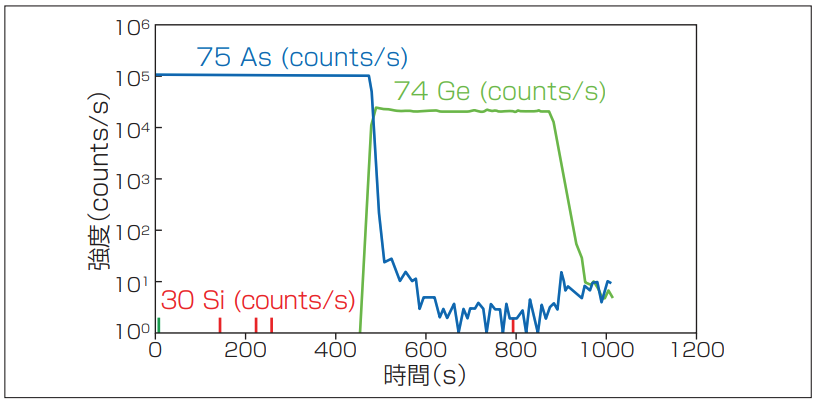
図2 二次イオン質量分光法(SIMS)計測から、トランスルーセント社の工程ではエピタキシャルレーザからのゲルマニウム(Ge)がInGaAs層に拡散しないことが分かる。

図3 走査型電子顕微鏡(SEM)画像は、Si-Ge-InGaAs層を示している。
(もっと読む場合は出典元へ)
出典元
https://ex-press.jp/wp-content/uploads/2014/02/201307_0024feature02.pdf
