UVレーザによるPCB製造工程の改善
急成長を続けるハイテクコンシューマ製品の市場を後押しするには、より高密度で、より小形なフィーチャに向かうPCB 設計が不可欠であり、言い換えれば、高度UV DPSSレーザシステムに適合する新しいレーザ加工能力が必要になる。
プリント基板(PCB)の設計は、各種デバイス、特にスマートフォン、タブレット、GPS デバイスなどのコンシューマエレクトロニクスの性能向上と小型化に向けた取り組みによって、その電気的な性能限界を押し広げている。集積回路(IC)製造が絶え間なく進歩することに伴い、デバイスインタフェースに必要とされる接続の数と密度は増加を続けている。
この動向は、言い換えれば、小口径のマイクロビアや高密度相互接続(HDI)パターンなどのPCBフィーチャのさらなる小形化および高密度化の必要性を高める。さらに、マルチチップ・モジュール(MCM)からボールグリッドアレイ(BGA)やチップスケールパッケージ(CSP)までの実装の進歩はウエハレベル処理にいたる寸法のギャップを徐々に狭めている。
これらの設計の材料加工要件を満たすものとして、紫外(UV)レーザはいっそう多くの用途を見出すだろう。UVレーザによる高エネルギー光子は、各種材料によって吸収され、それらをクリーンにアブレーションする。そして、その短い波長は強い集光を可能にするので、微細なフィーチャと高強度マシニングに有利である。
レーザビア穴あけ
ビア穴あけはPCB 製造におけるレーザのゲートウェイ応用である。1980年代後半(1)から1990年代(2)を通して実施された、PCB材料内の所定の距離終端する、いわゆる「ブラインドビア」
ホールを迅速に加工するレーザの能力はPCB製造にとって貴重なものであった。それは、積層ビルドアップ工程の進歩と相まって、常に縮小を続ける半導体デバイス製造ノードに追いつくために必要な多層PCB アーキテクチャを可能にした。
高密度実装用途向け小口径ブラインドビアの需要の増加が、急成長するレーザ市場を生み出した。最も厚いPCB内のスルービアは機械的に穴あけされることが多いが、大口径ブラインドビアにはCO2レーザが使用され、最先端のPCBアーキテクチャに見られる最も小さい直径のマイクロビアはUV(355nm)波長領域のナノ秒パルスQスイッチダイオードポンプ固体(DPSS)レーザで加工される。
典型的なブラインドビア穴あけ用途は、下地の銅層を露出させるための数10ミクロンのビルドアップ樹脂(例えばABF または味の素のビルドアップフィルム)の除去を含む。約50〜60μm以下のビアでは、CO2レーザの長い(約10μm)波長は強く集光するその能力に関連する大きな課題があり、比較的大きな溶融再キャストが現在のさらなる課題となっている。一方、短いナノ秒のQ スイッチング355nmパルスで起きるクリーンなアブレーションは、結果として高品質な溶融のないマイクロビアを形成する(図1)。
マイクロビアはサイズが小さく、355nm 波長を強く吸収するため、このアプリケーションはさほど高いパルスエネルギーを必要としない。数10 マイクロジュールもあれば十分である。しかし図1 に示されているように、非最適工程は、その後のメッキに適さない銅表面が残り、劣悪な結果をもたらす。最高品質の達成には、短いナノ秒レーザパルスとトップハットビーム成形(3)が使われる。そうすれば露出した銅表面の最小の損傷/酸化と最小の側壁テーパが得られる。これらはいずれも続く銅メッキ層の良好な接着強さを確保する上で不可欠である。
図1に示された、高品質マイクロビアはSpectra-Physics Hippo 355-5レーザシステム[50kHzのパルス繰返し周波数(PRF)で5Wのパワー]を使って形成された。このレーザでも毎秒約500ホールの高いスループットを達成できるが、さらに高度のビア穴あけツールは、今日入手可能なSpectra-Physics Pulseo355nm、20W レーザなどのさらに高出力のUVレーザの長所を利用して、ビア直径と樹脂厚さに依存して、毎秒2000ホールないしそれ以上のスループットを達成する。
ブラインドマイクロビアの穴あけは355nmのQスイッチDPSSレーザの主要なビア穴あけ用途であるが、最新世代のより強力なUVレーザはより厚く堅いPCB中のより大口径のビアの形成に有望である。これらの材料には、エポキシ樹脂と組み合わされたガラスファイバーも含まれるので、高いパルスエネルギーと短いパルス幅は有用である。例えば最近、Pulseo355-20 UVレーザが2.3mm厚の銅クラッドFR4材料に対する200μm直径のビア穴あけに使われた(図2)。
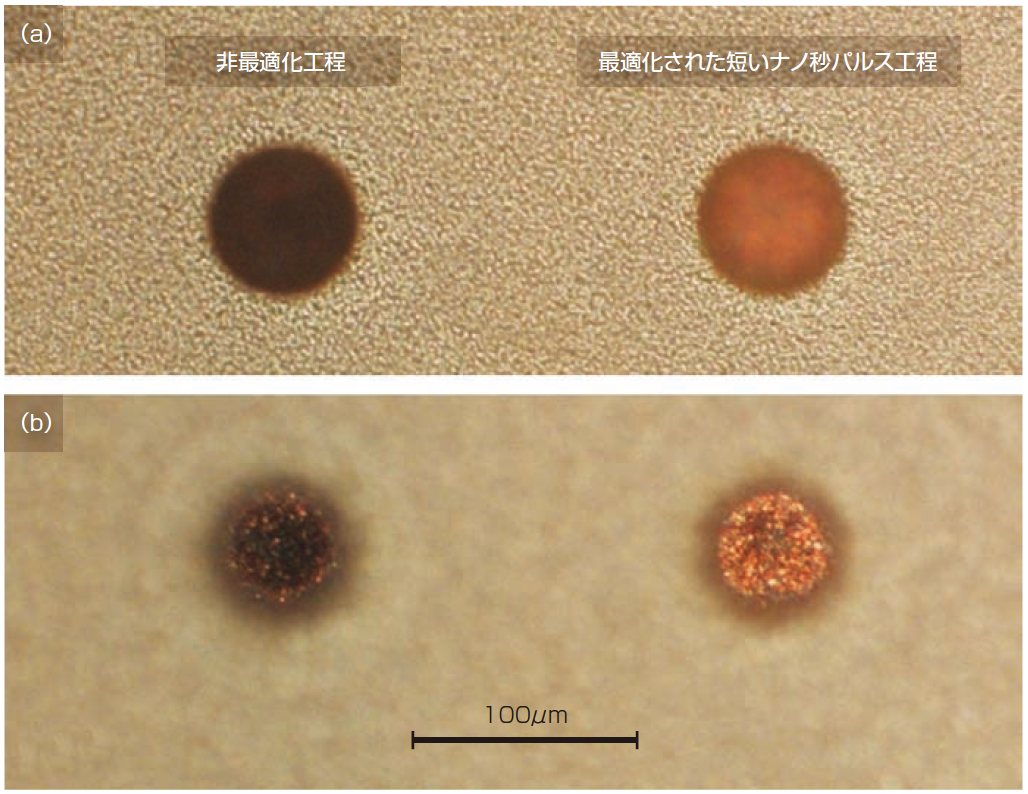
図1 GXシリーズビルドアップフィルムにおける直径60μmのPCBブラインドビアのABF 表面ビュー(a)と銅基板ビュー(b)。短いナノ秒パルスを使った最適化プロセスはメッキに適した銅表面を残した。
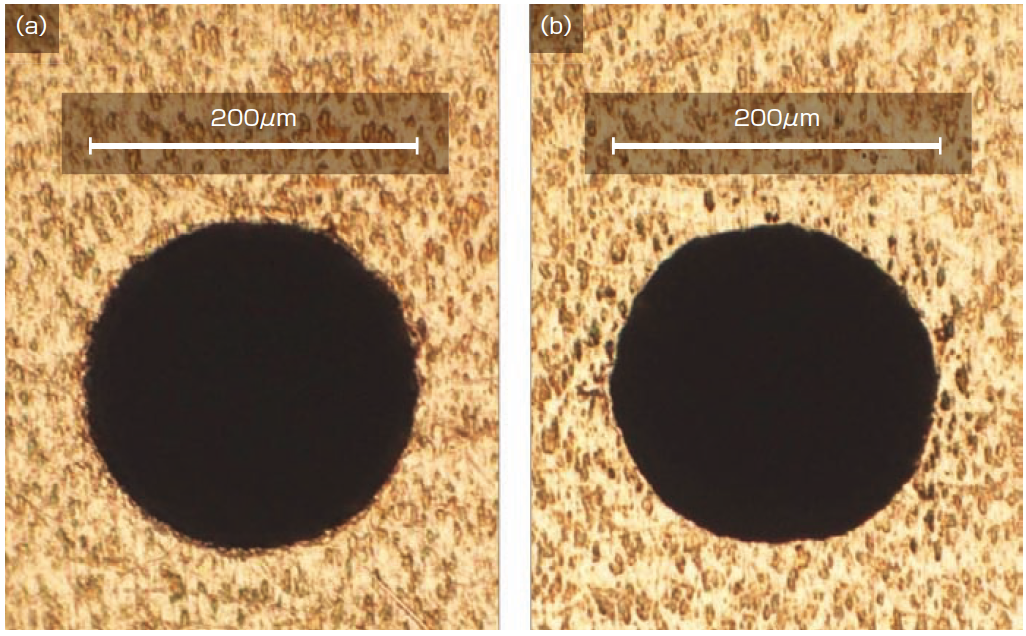
図2 厚さ2.3mm銅クラッドFR4ボードに高いアスペクト比でレーザ穴あけされた200μm径ビアの入口(a)と出口(b)表面;穴あけ速度は毎秒10ビアよりも大きい。
(もっと読む場合は出典元へ)
出典元
https://ex-press.jp/wp-content/uploads/2013/01/201301_0028feature03.pdf
