超低エネルギー消費量の超小型45GHzGeフォトダイオード
将来の通信ネットワークの帯域幅要求に応えるために、多くの研究所がシリコン(Si)フォトニクスと他の半導体プラットフォームをベースにしたフォトニクス統合アーキテクチャの開発を進めている。最近になって、米サンディア国立研究所、英IQEシリコン・コンパウンズ社、米マサチューセッツ工科大学(MIT)の研究チームは、サンディア国立研究所のCMOS対応のSiフォトニクスプロセスに必要なコンポーネントとして、1.2fFと非常に低い固有容量をもつ超小型・高速ゲルマニウム(Ge)フォトダイオードを開発した。これは、固有容量が非常に低いことにより、トランスインピーダンス増幅器(TIA)なしにトランジスタのゲートの直接駆動を可能にし、次世代通信リンクの電力消費量を劇的に低減するだろう(1)。
ボトムアップアプローチ
ブランケットエピタキシーを使った層成長、それに続いてリソグラフィおよびエッチング段階での材料除去からなる通常のSi上Geフォトダイオード製造プロセスの代わりに、研究チームはGeを酸化物ウィンドウ(窓)内に選択成長させる、ボトムアップアプローチを採用した。このアプローチでは、発生した転位が窓のエッジ部分で終端するため、検出器構造内の転位密度を低減し、暗電流を全体的に低く抑えることができる。
フォトダイオードの製造ステップは、Si台座の最上部にある酸化物のトレンチ内におけるホウ素ドープGeの選択その場成長を含む(図1)。このGeは被覆成長させ、化学機械研摩(CMP)によって最終的にGeの厚みが目標の0.6μmになったところで、導波路平坦化プロセスを終了した。フォトダイオードのn型層とトップ電極を形成するためにリンが注入された。続いて酸化物キャップ層を堆積して縦n-i-p 構造を完成させた。電気接点形状を追加したあと、プラズマ化学気相成長法(PECVD)によって2.5μm厚みの光学酸化物クラッド層を形成した。
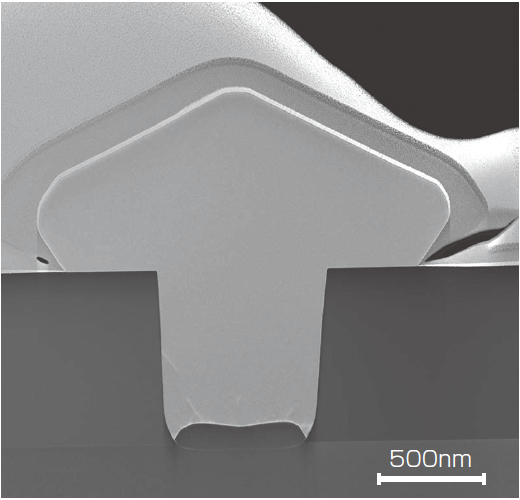
図1 透過型電子顕微鏡(TEM)断面像は、化学機械研摩(CMP)に先立ち選択領域エピタキシャル被覆成長させたゲルマニウム(Ge)構造を示している。このフォトダイオードのボトムアップ製造プロセスによって転位欠陥密度の低減が可能になる。(資料提供:サンディア国立研究所)
(もっと読む場合は出典元へ)
出典元
https://ex-press.jp/wp-content/uploads/2012/03/201203_0012wn01.pdf
