走査型電子顕微鏡(Scanning Electron Microscope:SEM)とは電子顕微鏡の一種で、タングステンフィラメント等から照射される電子線を試料表面に走査させ、資料から放出される2次電子、反射電子、透過電子、X線、カソードルミネッセンス(蛍光)等の信号を画像化する顕微鏡である。一般的には信号強度の大きい2 次電子を検出することで像を得る。図1はSEMの概念図である。
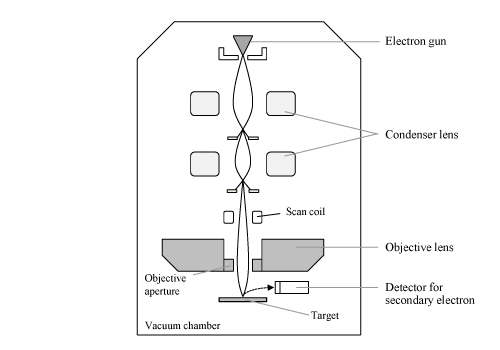
図1:走査型電子顕微鏡の概念図
電子は低NAでも小さく絞ることができるので、大きな焦点深度と高い分解能を実現しており、微細構造観察では最も一般的に使用される。分解能は電子銃の種類にもよるが5nm以下である。
観察対象物が絶縁体の場合は電子線の照射とともに試料に電荷がたまりコントラストが低下するので、必要に応じ試料表面を薄い金属膜で覆うか試料と試料台を電気的に導通があるようにして試料台を通してアースし観察を行う。
電子プローブ微小分析
電子プローブ微小分析( Electron Probe Micro Analyzer:EPMA)は電子線照射によって発生する特定X線を検出することで、試料表面の構成元素の同定と各構成元素の比率を分析する装置である。走査型電子顕微鏡のオプション機能として用いられる。特定X 線の検出には波長分散型分光器(Wavelength Dispersive Spectrometer: WDS)、またはエネルギー分散型分光器(Energy Dispersive Spectrometer: EDS)が用いられる。
WDS はブラッグの回折条件を満たす波長のX 線だけを結晶格子でよりわけ、X 線比例計測管などで検出するものである。WDS はX 線の波長分解能は高いが測定に必要になる電子ビーム電流をEDS に比べて2 桁程度高くする必要がある。
一方、EDS は入射したX 線のエネルギーに比例した数の電子正孔対を発生させる液体窒素冷却されたLi ドープのSi 半導体を用いた検出方法である。EDS は電子線による試料の破損が抑えられ、比較的短時間で計測することができる。しかしその波長分解能はWDS に比べて1 桁以上悪い。
測定ではこれらの点を考慮して計測の目的に応じて適当な検出方法が用いられる.
電子後方散乱回折像法
電子後方散乱回折像法(Electron Backscatter Diffraction:EBSD)は後方散乱電子回折を利用して試料表面から数10 nm の深さの結晶方位解析を行う方法であり、SEMに組み込まれる形で利用される。図2は電子後方散乱回折像の概念図である。
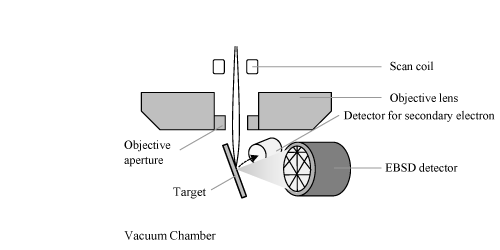
図2:電子後方散乱回折法の概念図
試料を鏡筒内で70 度程度傾けて設置し、そこに電子線を照射する。すると電子後方散乱回折パターンが電子線とほぼ90 度の位置に設置されたスクリーン上に投影される。このパターンを高感度カメラで取り込み、コンピュータで既知の結晶系を用いたシミュレーションによるパターンとの比較することにより方位が決定される。試料上のグレインサイズを容易に測定することができるため、TFT デバイス用の薄膜Si プロセス(a-Si 薄膜の結晶化)の評価に盛んに用いられるようになった。
参考文献
- パルスレーザー誘起構造変化の計測とその応用-フェムト秒レーザーによる半導体高速転移及びナノ秒レーザーによるデブリフリーダイシング技術の開発、井澤友策
- レーザー加工機
- 高精度ファイバーレーザー切断機
